硅片檢測(cè)
實(shí)驗(yàn)室擁有眾多大型儀器及各類分析檢測(cè)設(shè)備,研究所長期與各大企業(yè)、高校和科研院所保持合作伙伴關(guān)系,始終以科學(xué)研究為首任,以客戶為中心,不斷提高自身綜合檢測(cè)能力和水平,致力于成為全國科學(xué)材料研發(fā)領(lǐng)域服務(wù)平臺(tái)。
立即咨詢網(wǎng)頁字號(hào):【大 中 小 】 | 【打印】 【關(guān)閉】 微信掃一掃分享:
注意:因業(yè)務(wù)調(diào)整,暫不接受個(gè)人委托測(cè)試望見諒。
聯(lián)系中化所
哪里可以檢測(cè)硅片?中析研究所檢測(cè)中心提供硅片檢測(cè)服務(wù),出具的硅片檢測(cè)報(bào)告支持掃碼查詢真?zhèn)巍7?wù)項(xiàng)目:元素分析、表面形貌、顯微結(jié)構(gòu)、結(jié)構(gòu)分析、物理性能、薄膜厚度、電性能、化學(xué)成分等。實(shí)驗(yàn)室工程師嚴(yán)格按照相關(guān)標(biāo)準(zhǔn)進(jìn)行實(shí)驗(yàn),并且提供非標(biāo)實(shí)驗(yàn)定制服務(wù)。
檢測(cè)周期:7-15個(gè)工作日,參考周期
檢測(cè)樣品
單晶硅片、多晶硅片、SOI硅片、玻璃硅片、氮化硅片。
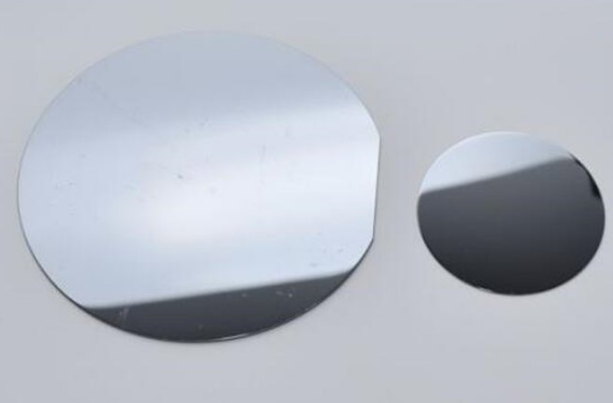
檢測(cè)項(xiàng)目
元素分析、表面形貌、顯微結(jié)構(gòu)、結(jié)構(gòu)分析、物理性能、薄膜厚度、電性能、化學(xué)成分。
檢測(cè)方法
表面形貌和顯微結(jié)構(gòu)分析:掃描電子顯微鏡、光學(xué)顯微鏡。
結(jié)構(gòu)分析:X射線衍射。
物理性能測(cè)試:硬度計(jì)、彈性模量測(cè)量儀。
電性能測(cè)試:電阻測(cè)試儀、載流子遷移率測(cè)量儀。
元素分析:原子吸收光譜、電感耦合等離子體發(fā)射光譜、X射線熒光光譜。
薄膜厚度測(cè)量:表面粗糙度儀、白光干涉儀。
化學(xué)成分分析:滴定法、離子色譜法。
表面清潔度測(cè)試:核磁共振、紅外光譜。
檢測(cè)儀器
掃描電子顯微鏡、原子力顯微鏡、光學(xué)顯微鏡、X射線衍射儀、電子探針微區(qū)分析儀、薄膜厚度計(jì)、電子束曝光儀、硬度計(jì)、彈性模量測(cè)量儀、紅外光譜儀、電感耦合等離子體發(fā)射光譜。


檢測(cè)標(biāo)準(zhǔn)
GB/T 6616-2009 半導(dǎo)體硅片電阻率及硅薄膜薄層電阻測(cè)試方法 非接觸渦流法
GB/T 6617-2009 硅片電阻率測(cè)定 擴(kuò)展電阻探針法
GB/T 6618-2009 硅片厚度和總厚度變化測(cè)試方法
GB/T 6619-2009 硅片彎曲度測(cè)試方法
GB/T 6620-2009 硅片翹曲度非接觸式測(cè)試方法
GB/T 6621-2009 硅片表面平整度測(cè)試方法
GB/T 11073-2007 硅片徑向電阻率變化的測(cè)量方法
GB/T 13388-2009 硅片參考面結(jié)晶學(xué)取向X射線測(cè)試方法
GB/T 14140-2009 硅片直徑測(cè)量方法
GB/T 19444-2004 硅片氧沉淀特性的測(cè)定-間隙氧含量減少法





 掃一掃關(guān)注公眾號(hào)
掃一掃關(guān)注公眾號(hào)

